
Au cours du processus de fabrication des puces semi-conductrices, il est nécessaire d'utiliser des techniques de tranchage pour découper les plaquettes. Toutefois, la découpe traditionnelle au diamant et à la meule peut endommager considérablement les matériaux semi-conducteurs, ce qui entraîne des problèmes tels que la fragmentation des plaquettes et la dégradation des performances des puces. Par conséquent, le développement de technologies de coupe avancées revêt une importance considérable pour le coût [...]
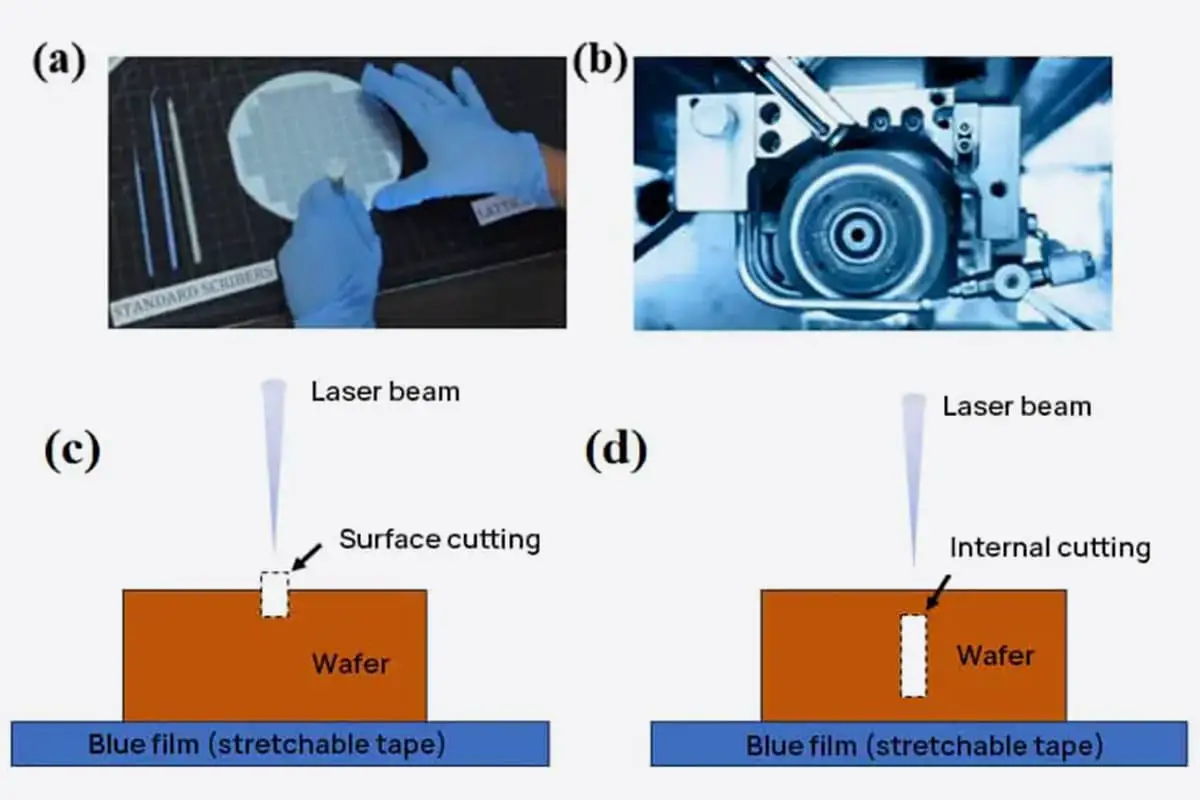
Au cours du processus de fabrication des puces semi-conductrices, il est nécessaire d'utiliser des techniques de tranchage pour découper les plaquettes. Toutefois, la découpe traditionnelle au diamant et à la meule peut endommager considérablement les matériaux semi-conducteurs, ce qui entraîne des problèmes tels que la fragmentation des plaquettes et la dégradation des performances des puces.
Par conséquent, le développement de technologies de découpe avancées revêt une importance considérable pour la réduction des coûts et l'amélioration de l'efficacité dans l'industrie des semi-conducteurs à circuits intégrés. Avec les progrès de la technologie laser, la découpe par ablation laser à haute puissance (c'est-à-dire la découpe laser) et la découpe furtive réalisée à l'aide de lasers focalisés de faible puissance deviennent progressivement des technologies courantes de découpe des puces.
Découpe au laser est une méthode de traitement sans contact qui, contrairement au découpage traditionnel au diamant et à la meule, permet d'éviter les pertes de copeaux, l'usure de l'outil, la pollution de l'eau, les effets thermiques et le piégeage des copeaux, qui sont des problèmes importants.
Cependant, les lasers à haute puissance utilisés dans la découpe par ablation laser génèrent des effets thermiques importants pendant le fonctionnement, ce qui peut facilement endommager le film bleu au fond pendant la découpe de la plaquette, ce qui a un impact sur la technique de traitement des puces. C'est pourquoi la technologie de découpe furtive est progressivement devenue un point central dans l'industrie de fabrication des semi-conducteurs.
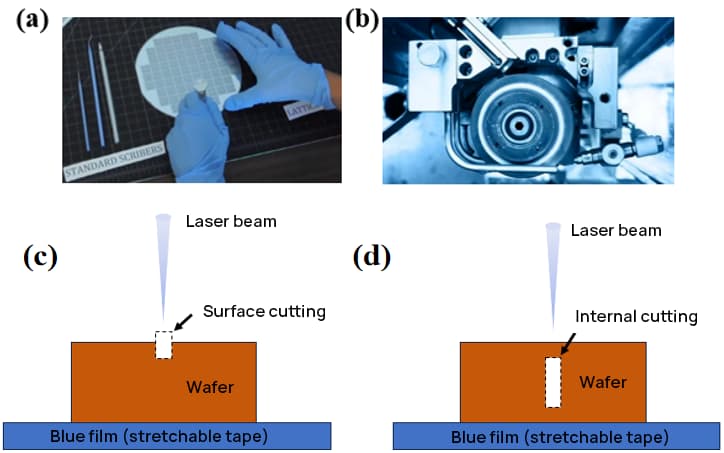
La technologie Stealth Dicing, en concentrant un laser pour former une petite zone de spot lumineux, peut générer une énorme densité d'énergie, permettant ainsi de découper les plaquettes de silicium.
En tant que procédé sec, le Stealth Dicing offre des avantages tels qu'une vitesse élevée, une qualité élevée (pas ou très peu de copeaux) et une faible consommation d'énergie. kerf perte. Le processus spécifique du Stealth Dicing peut être divisé en deux étapes :
(1) Perforation induite par laser : Comme le montre la figure 2, un faisceau laser pulsé pouvant traverser la plaquette est focalisé sous la surface de la plaquette par le système optique. Lorsque le faisceau puissance du laser La densité à ce point de focalisation atteint son maximum, une perforation est formée, et à ce stade, les puces sur la plaquette ne sont pas encore séparées.
(2) Séparation des puces : Après le dépliage de la pellicule bleue placée sur la plaquette, en raison des importantes contraintes de traction et de compression présentes à proximité de l'extrémité de la plaquette, il se produit une séparation de la plaquette. perforation au laserDes fissures peuvent être induites le long de la trajectoire du laser à l'intérieur de la plaquette, ce qui permet d'obtenir une séparation de la puce.
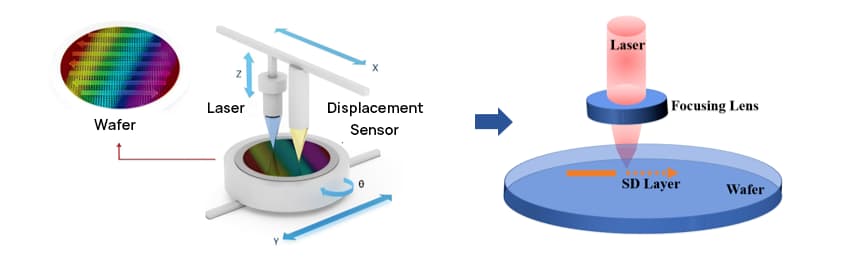
La technologie de découpe laser furtive a maintenant été appliquée dans une variété de scénarios de découpe de plaquettes, tels que :
(1) Découpe de plaquettes de silicium : Lors de l'utilisation de lames diamantées conventionnelles pour couper le silicium, l'épaisseur, la granularité, la rotation et la vitesse de coupe de la lame affectent de manière significative la qualité de la coupe. Malgré des années d'améliorations techniques, la grande largeur de coupe (kerf) causée par la lame entraîne toujours des pertes de matériau.
En outre, la production de débris et l'usure des lames augmentent les coûts de coupe. Toutefois, l'utilisation de la technologie de découpe laser furtive avec une trajectoire de coupe ultra étroite peut éliminer les problèmes de coûts liés au nettoyage des débris supplémentaires et au gaspillage de matériaux, améliorant ainsi la productivité des copeaux. En outre, en évitant les dommages thermiques, la technologie de découpe laser furtive peut encore améliorer le rendement de la fabrication des puces.
(2) Découpe du carbure de silicium : Le carbure de silicium est un matériau ultra-dur, le deuxième après le diamant en termes de dureté, ce qui le rend extrêmement difficile à usiner. Dans la préparation de matériaux de substrat cristallin en carbure de silicium de grande taille (6 pouces et plus), la technologie de découpe laser furtive, comparée à la technologie de découpe par fil abrasif fixe (diamant déposé par électrolyse sur un fil d'acier), peut améliorer l'efficacité de la découpe de 3 à 5 fois.
Compte tenu de l'importance de la consommation de matériaux, la technologie de découpe laser furtive peut également augmenter le taux de production des plaquettes de carbure de silicium de plus de 30%.
(3) Découpe de plaquettes spéciales : Lorsque la technologie de découpe laser furtive est utilisée pour découper des plaquettes spéciales (par exemple, des plaquettes avec des films minces de montage de puces ou fabriquées avec des matériaux à faible k), il est possible d'éviter la génération de fractures et de fissures, ce qui permet d'obtenir une découpe de plaquettes de haute efficacité et de haute précision.

Malgré les nombreux avantages de la technologie de découpe furtive au laser, une série de problèmes interfèrent encore avec le processus de découpe. Comme le montre la figure 4, le gauchissement de la surface de la plaquette et les problèmes liés à la gestion de la densité d'énergie du laser peuvent empêcher le processus de découpe. focalisation laser de se poser avec précision sur des couches minces spécifiques à l'intérieur de la plaquette, ce qui empêche d'améliorer la précision de la coupe et le taux de rendement des copeaux.
En raison de la difficulté à appliquer uniformément le faisceau laser pendant les phases d'accélération, de décélération et de virage, des problèmes de surtraitement peuvent facilement se produire. En outre, des problèmes tels que les interférences analogiques, la non-linéarité analogique, la dérive analogique ou les retards dans la boucle de courant du pilote affecteront la précision du contrôle et la réactivité de la plate-forme de découpe laser.
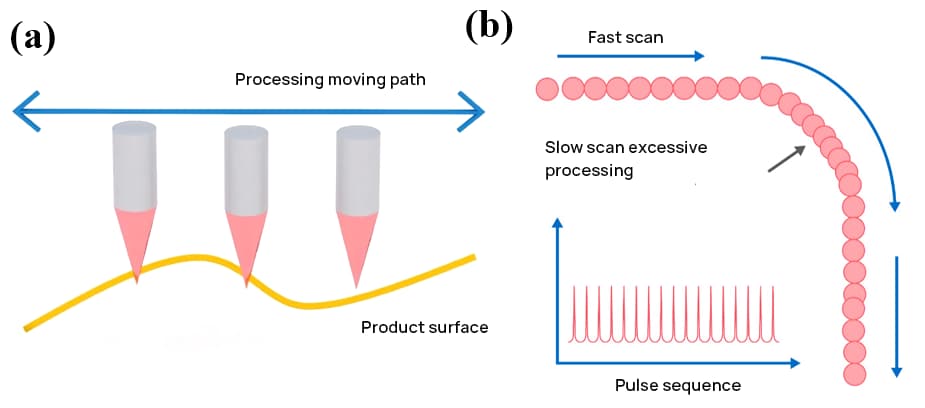
En réponse à ces problèmes, les secteurs universitaire et industriel ont proposé une série de solutions, comme le montre la figure 5 :
(1) Contrôle de la hauteur en temps réel : Pendant le processus de découpe de la plaquette, des capteurs de déplacement sont utilisés pour mesurer en temps réel d'infimes variations de hauteur sur la surface du produit. Ces variations sont compensées en temps réel sur l'axe Z où se trouve le laser, ce qui garantit que le laser se concentre précisément sur une fine couche spécifique de la plaquette.
(2) Contrôle de sortie de la comparaison de position à grande vitesse : Le développement d'un algorithme de suivi de la hauteur permet d'éviter efficacement les problèmes d'usinage excessif lors de l'accélération, de la décélération et du virage du laser, en garantissant que le laser agit uniformément sur la pièce.
(3) Technologie de contrôle PWM (Pulse Width Modulation) : En émettant directement des signaux de commutation numériques à partir du contrôleur, qui sont ensuite amplifiés par un module d'amplification de puissance pour contrôler directement la boucle de courant du moteur, on obtient une amélioration plus rapide et plus directe de la précision de contrôle et de la réactivité de la plate-forme de découpe laser.

En ce qui concerne la petite zone d'action et le problème de réglage de la puissance du découpage furtif par laser à focale unique, une technologie de découpage furtif par laser à focale multiple a été spécialement mise au point. Cette technique permet de focaliser et de générer simultanément plusieurs points focaux à l'intérieur de la plaquette pour la découper, ce qui augmente considérablement l'efficacité de la découpe, comme le montre la figure 6.
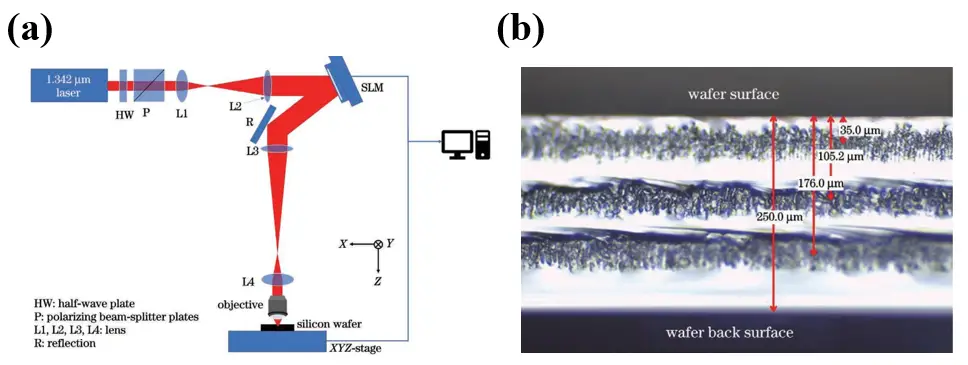
Au cours du processus de découpe multifocale au laser, la position et l'intensité du faisceau laser influencent grandement la qualité de la découpe. En raison de la différence significative des indices de réfraction entre l'air et les matériaux semi-conducteurs, le faisceau laser agissant à l'intérieur de la plaquette peut provoquer un phénomène de dispersion du point focal, ce qui nécessite une correction de l'aberration.
Pour répondre aux besoins de découpe des plaquettes de silicium dans divers scénarios d'application, les chercheurs ont abordé ces questions grâce à des avancées techniques, telles que la régulation de la position et de l'intensité des foyers multiples et le développement de technologies de correction de l'aberration pour surmonter la dispersion du point focal.
Par rapport aux technologies de découpe traditionnelles, la découpe laser furtive présente des avantages notables dans les applications pratiques, notamment une efficacité nettement plus élevée, une qualité supérieure et des pertes moindres.
En continuant d'optimiser et d'explorer la technologie du laser stealth dicing, par exemple en ajustant l'énergie du faisceau pendant le processus de stealth dicing pour obtenir une rugosité de la surface de la puce photonique, ou en améliorant l'efficacité du laser stealth dicing, nous sommes fermement convaincus que cette technologie brillera dans le domaine de la fabrication de semi-conducteurs à circuits intégrés, ainsi que dans d'autres domaines émergents.

En tant que fondateur de MachineMFG, j'ai consacré plus d'une décennie de ma carrière à l'industrie métallurgique. Ma vaste expérience m'a permis de devenir un expert dans les domaines de la fabrication de tôles, de l'usinage, de l'ingénierie mécanique et des machines-outils pour les métaux. Je suis constamment en train de réfléchir, de lire et d'écrire sur ces sujets, m'efforçant constamment de rester à la pointe de mon domaine. Laissez mes connaissances et mon expertise être un atout pour votre entreprise.











